2024 Forfatter: Howard Calhoun | [email protected]. Sidst ændret: 2023-12-17 10:22
Ionimplantation er en lavtemperaturproces, hvorved komponenterne i et enkelt element accelereres ind i den faste overflade af en wafer, hvorved dens fysiske, kemiske eller elektriske egenskaber ændres. Denne metode bruges i produktionen af halvlederenheder og i metalbearbejdning, såvel som i materialevidenskabelig forskning. Komponenter kan ændre pladens grundstofsammensætning, hvis de stopper og forbliver i den. Ionimplantation forårsager også kemiske og fysiske ændringer, når atomer kolliderer med et mål ved høj energi. Pladens krystallinske struktur kan blive beskadiget eller endda ødelagt af energikaskader af kollisioner, og partikler med tilstrækkelig høj energi (10 MeV) kan forårsage nuklear transmutation.
Generelt princip for ionimplantation

Udstyr består norm alt af en kilde, hvor atomer af det ønskede grundstof dannes, en accelerator, hvor de elektrostatisk accelereres til en højenergi, og målkamre, hvor de kolliderer med målet, som er materialet. Denne proces er således et særligt tilfælde af partikelstråling. Hver ion er norm alt et enkelt atom eller molekyle, og derfor er den faktiske mængde materiale implanteret i målet tidsintegralet af ionstrømmen. Dette tal kaldes dosis. Strømmene, der leveres af implantater, er norm alt små (mikroampere), og derfor er den mængde, der kan implanteres inden for rimelig tid, lille. Derfor anvendes ionimplantation i tilfælde, hvor antallet af krævede kemiske ændringer er lille.
Typiske ionenergier spænder fra 10 til 500 keV (1600 til 80000 aJ). Ionimplantation kan anvendes ved lave energier i området fra 1 til 10 keV (160 til 1600 aJ), men penetrationen er kun nogle få nanometer eller mindre. Effekt under dette resulterer i meget lidt skade på målet og falder ind under betegnelsen ionstråleaflejring. Og højere energier kan også bruges: acceleratorer, der er i stand til 5 MeV (800.000 aJ) er almindelige. Der er dog ofte meget strukturelle skader på målet, og fordi dybdefordelingen er bred (Bragg peak), vil nettoændringen i sammensætning på ethvert punkt på målet være lille.
Ionernes energi, såvel som forskellige typer atomer og sammensætningen af målet, bestemmer dybden af partiklers indtrængning i et fast stof. En monoenergetisk ionstråle har norm alt en bred dybdefordeling. Den gennemsnitlige penetration kaldes området. PÅunder typiske forhold vil det være mellem 10 nanometer og 1 mikrometer. Lavenergiionimplantation er således særlig nyttig i tilfælde, hvor det ønskes, at den kemiske eller strukturelle ændring er nær måloverfladen. Partikler mister gradvist deres energi, når de passerer gennem et fast stof, både fra tilfældige kollisioner med målatomer (som forårsager bratte energioverførsler) og fra let deceleration fra overlapningen af elektronorbitaler, som er en kontinuerlig proces. Energitabet af ioner i et mål kaldes stalling og kan modelleres ved hjælp af ionimplantationsmetoden for den binære kollisionstilnærmelse.
Acceleratorsystemer er generelt klassificeret i medium strøm, høj strøm, høj energi og meget betydelige doser.
Alle varianter af ionimplantationsstråledesign indeholder visse almindelige grupper af funktionelle komponenter. Overvej eksempler. Det første fysiske og fysisk-kemiske grundlag for ionimplantation omfatter en enhed kendt som en kilde til at generere partikler. Denne enhed er tæt forbundet med forspændte elektroder til at udtrække atomer i strålelinjen og oftest med nogle midler til at vælge specifikke transportformer til hovedsektionen af acceleratoren. Valget af "masse" er ofte ledsaget af passagen af den udtrukne ionstråle gennem et område af magnetfelt med en udgangsvej begrænset af blokerende huller eller "sp alter", der kun tillader ioner med en vis værdi af produktet af masse og hastighed. Hvis måloverfladen er større end ionstrålediameteren oghvis den implanterede dosis er mere jævnt fordelt over den, så bruges en kombination af strålescanning og pladebevægelse. Endelig er målet forbundet med en måde at opsamle den akkumulerede ladning af de implanterede ioner på, så den afgivne dosis kan måles kontinuerligt og processen stoppes på det ønskede niveau.
Anvendelse i halvlederfremstilling
Doping med bor, fosfor eller arsen er en almindelig anvendelse af denne proces. Ved ionimplantation af halvledere kan hvert dopantatom skabe en ladningsbærer efter annealing. Du kan bygge et hul til en p-type dopingmiddel og en n-type elektron. Dette ændrer ledningsevnen af halvlederen i dens nærhed. Teknikken bruges f.eks. til at justere tærsklen for en MOSFET.
Ionimplantation blev udviklet som en metode til at opnå en pn-forbindelse i fotovoltaiske enheder i slutningen af 1970'erne og begyndelsen af 1980'erne, sammen med brugen af en pulseret elektronstråle til hurtig annealing, selvom den ikke er blevet kommercialiseret til dato.
Silicon på isolator

En af de velkendte metoder til fremstilling af dette materiale på isolatorsubstrater (SOI) fra konventionelle siliciumsubstrater er SIMOX-processen (separation ved oxygenimplantation), hvor højdosis luft omdannes til siliciumoxid gennem en højtemperaturudglødningsproces.
Mesotaxy
Dette er betegnelsen for vækst krystallografisksammenfaldende fase under overfladen af hovedkrystallen. I denne proces implanteres ioner med en tilstrækkelig høj energi og dosis i materialet til at skabe et anden fase lag, og temperaturen styres, så målstrukturen ikke ødelægges. Lagets krystalorientering kan designes, så det passer til formålet, selvom den nøjagtige gitterkonstant kan være meget forskellig. For eksempel, efter implantation af nikkelioner i en siliciumwafer, kan der dyrkes et lag silicid, hvor krystalorienteringen svarer til siliciums.
Metalfinish-applikation

Nitrogen eller andre ioner kan implanteres i et værktøjsstålmål (såsom en boremaskine). Den strukturelle ændring inducerer overfladekompression i materialet, hvilket forhindrer revneudbredelse og dermed gør det mere modstandsdygtigt over for brud.
Overfladefinish

I nogle applikationer, for eksempel til proteser såsom kunstige led, er det ønskeligt at have et mål, der er meget modstandsdygtigt over for både kemisk korrosion og slid på grund af friktion. Ionimplantation bruges til at designe overfladerne på sådanne enheder til mere pålidelig ydeevne. Som med værktøjsstål omfatter målmodifikation forårsaget af ionimplantation både overfladekompression for at forhindre revneudbredelse og legering for at gøre det mere kemisk modstandsdygtigt over for korrosion.
Andetapplikationer

Implantation kan bruges til at opnå blanding af ionstråler, det vil sige blanding af atomer af forskellige elementer ved grænsefladen. Dette kan være nyttigt til at opnå graduerede overflader eller forbedre vedhæftningen mellem lag af ikke-blandbare materialer.
Danning af nanopartikler
Ionimplantation kan bruges til at inducere materialer i nanoskala i oxider som safir og siliciumdioxid. Atomer kan dannes som følge af udfældning eller dannelse af blandede stoffer, der indeholder både et ionimplanteret grundstof og et substrat.
Typiske ionstråleenergier, der bruges til at opnå nanopartikler, er i området fra 50 til 150 keV, og ionfluensen er fra 10-16 til 10-18 kV. se En lang række materialer kan dannes med størrelser fra 1 nm til 20 nm og med sammensætninger, der kan indeholde implanterede partikler, kombinationer, der udelukkende består af en kation bundet til substratet.
Dielektrisk-baserede materialer såsom safir, som indeholder spredte nanopartikler af metalionimplantation, er lovende materialer til optoelektronik og ikke-lineær optik.
Problems
Hver individuel ion producerer mange punktdefekter i målkrystallen ved stød eller interstitial. Ledige stillinger er gitterpunkter, der ikke er optaget af et atom: i dette tilfælde kolliderer ionen med målatomet, hvilket fører til overførsel af en betydelig mængde energi til det, så det forlader sitgrund. Dette målobjekt bliver selv et projektil i et fast legeme og kan forårsage successive kollisioner. Mellemrum opstår, når sådanne partikler stopper i et fast stof, men ikke finder ledig plads i gitteret at leve i. Disse punktdefekter under ionimplantation kan migrere og klynge sig sammen med hinanden, hvilket fører til dannelsen af dislokationsløkker og andre problemer.
Amorphization
Mængden af krystallografisk beskadigelse kan være tilstrækkelig til fuldstændig at omdanne måloverfladen, dvs. den skal blive et amorft fast stof. I nogle tilfælde er fuldstændig amorfisering af målet at foretrække frem for en krystal med en høj grad af defekt: en sådan film kan genvokse ved en lavere temperatur, end der kræves til udglødning af en alvorligt beskadiget krystal. Amorfisering af substratet kan forekomme som følge af stråleændringer. For eksempel, når man implanterer yttriumioner i safir ved en stråleenergi på 150 keV op til en fluens på 510-16 Y+/sq. cm, dannes et glasagtigt lag ca. 110 nm tykt, målt fra den ydre overflade.
Spray

Nogle af kollisionshændelserne får atomer til at blive udstødt fra overfladen, og dermed vil ionimplantation langsomt ætse overfladen væk. Effekten er kun mærkbar ved meget store doser.
Ion-kanal

Hvis en krystallografisk struktur påføres målet, især i halvledersubstrater, hvor det er mereer åben, så stopper specifikke retninger meget mindre end andre. Resultatet er, at rækkevidden af en ion kan være meget større, hvis den bevæger sig nøjagtigt langs en bestemt bane, såsom i silicium og andre kubiske diamantmaterialer. Denne effekt kaldes ionkanalisering og er, som alle lignende effekter, meget ikke-lineær, med små afvigelser fra den ideelle orientering, hvilket resulterer i betydelige forskelle i implantationsdybden. Af denne grund kører de fleste et par grader uden for aksen, hvor små justeringsfejl vil have mere forudsigelige effekter.
Anbefalede:
Ustruktureret ledelse: beskrivelse af koncept, metoder og metoder

Generel beskrivelse af konceptet med strukturløse metoder til at lede mennesker. Hvordan adskiller de sig fra den strukturelle måde at manipulere på. Beskrivelse af forskellige metoder og metoder til ustruktureret forv altning af samfundet. Ledelse af andre mennesker gennem ledere. Bringe illustrative eksempler på sådan ledelse
Dræning af jorden: koncept, formål, metoder og arbejdsmetoder

Vanding og dræning af jord er meget vigtige tiltag, der har til formål at forbedre betingelserne for normal vækst og udvikling af planter. De fleste nybegyndere har ikke spørgsmål om højkvalitetsvanding, men ikke alle ved, hvad dræning er. Så hvorfor skal du dræne jorden, i hvilke tilfælde skal du gøre det, hvordan man korrekt udfører denne procedure, og hvad det vil give
Lægning af kommunikation: typer, klassifikation, metoder og metoder til lægning, formål med kommunikation

Læggekommunikation er et af de vigtigste stadier i opførelsen af for eksempel et nyt boligbyggeri. Til dato er der et stort antal af de mest forskellige måder at installere kommunikation på. Deres egenskaber såvel som fordele og ulemper har ført til, at der vælges en individuel metode for hvert enkelt tilfælde
Ytterbiumfiberlaser: enhed, driftsprincip, strøm, produktion, anvendelse
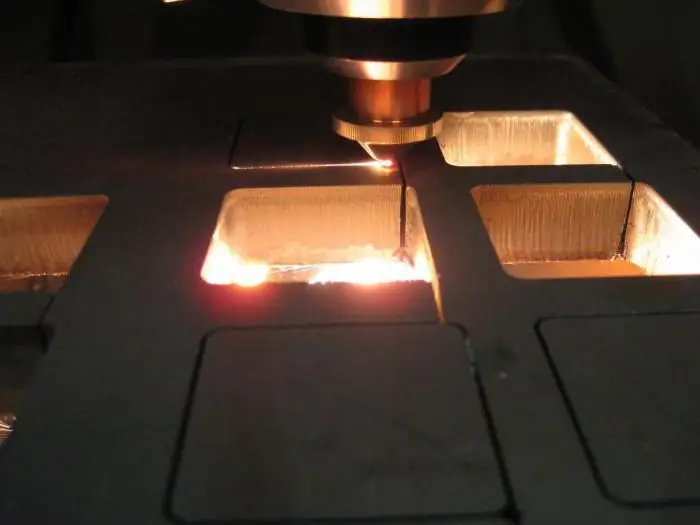
Fiberlasere er kompakte og robuste, peger præcist og spreder let termisk energi. De kommer i mange former og har meget til fælles med andre typer optiske kvantegeneratorer og har deres egne unikke fordele
Hvad er et vandmærke: koncept, behov for anvendelse på dokumenter, formål

Alle ved, hvad et vandmærke er. Den mest almindelige mulighed er vandmærker på pengesedler. Sådanne vandmærker, som kun er synlige i lyset, blev placeret på nominelt papir, frimærker og i den moderne version - på multimedieprodukter. På trods af den ret store alder af denne teknik, er det stadig den mest effektive måde at beskytte pengesedler rundt om i verden i dag








